Os materiais semicondutores desempenham um papel crucial em dispositivos como chips de memória e células solares, mas defeitos microscópicos em seu interior podem dificultar o transporte de corrente e afetar o desempenho. Uma equipe conjunta do Instituto Avançado de Ciência e Tecnologia da Coreia (KAIST) e do Centro de Pesquisa da IBM desenvolveu recentemente um novo método analítico capaz de detectar essas "armadilhas de elétrons" críticas com sensibilidade aproximadamente 1000 vezes maior do que as tecnologias existentes. (Um diagrama conceitual do desenvolvimento da tecnologia de caracterização (análise) do efeito Hall é apresentado.)
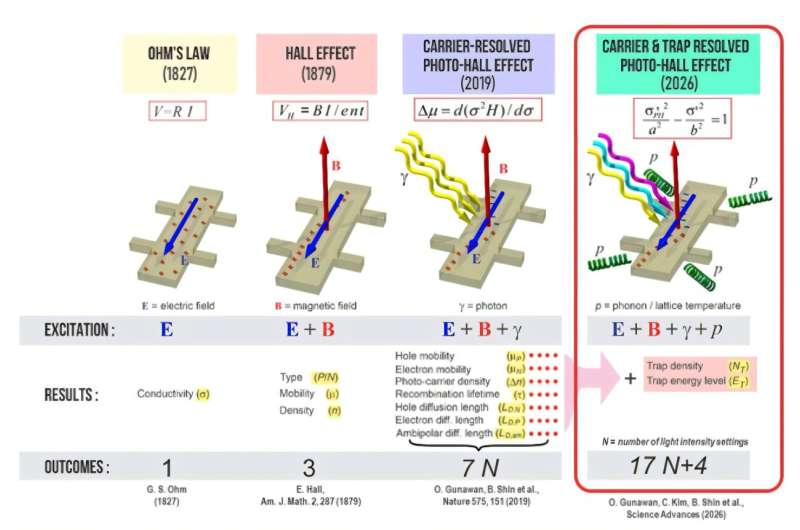
Essa conquista, publicada na revista Science Advances, foi co-liderada pelo Professor Shin Byung-ha, do Departamento de Ciência e Engenharia de Materiais do KAIST, e pelo Dr. Gang Man-dae-soo, da IBM, tendo a doutoranda Kim Chae-yeon como primeira autora. Essa tecnologia de detecção de defeitos em semicondutores visa analisar simultaneamente as características das armadilhas que dificultam o transporte de elétrons e o comportamento do transporte de portadores de carga dentro do material, fornecendo dados cruciais para a otimização do desempenho do material.
As armadilhas de elétrons em semicondutores capturam elétrons livres, levando ao aumento da corrente de fuga e à diminuição do desempenho do dispositivo. Os métodos tradicionais de avaliação enfrentam desafios na quantificação precisa da densidade de armadilhas e sua capacidade de aprisionamento. A equipe de pesquisa aprimorou de forma inovadora o método clássico de medição de Hall, introduzindo variações controláveis de iluminação e temperatura, extraindo com sucesso informações que antes eram difíceis de obter. Em condições de baixa luminosidade, os elétrons recém-gerados são preferencialmente aprisionados; à medida que a iluminação aumenta, as armadilhas se preenchem, permitindo que os elétrons se movam livremente. A análise desse processo dinâmico possibilita o cálculo preciso da densidade e das características das armadilhas de elétrons.
A principal vantagem desse método é a capacidade de adquirir informações multidimensionais em uma única medição, avaliando não apenas a mobilidade, o tempo de vida e a distância de difusão dos elétrons, mas também analisando diretamente as propriedades das armadilhas que interferem no transporte. A equipe verificou inicialmente a precisão dessa nova técnica de medição em semicondutores de silício e, em seguida, a aplicou à perovskita, um material promissor para células solares de próxima geração, detectando com sucesso defeitos extremamente pequenos, difíceis de detectar por métodos tradicionais.
O professor Shin Byung-ha destacou: "Esta pesquisa propõe um novo método que permite analisar simultaneamente o transporte elétrico e seus fatores limitantes em semicondutores por meio de uma única medição." Ele afirmou que isso se tornará uma ferramenta importante para melhorar o desempenho e a confiabilidade de diversos dispositivos, incluindo semicondutores de memória e células solares. Espera-se que essa técnica analítica de alta sensibilidade reduza o ciclo de P&D de materiais semicondutores, diminua os custos de desenvolvimento e, em última análise, melhore a vida útil do produto e a eficiência energética.